flip chip属于几级封装(晶圆级封装WLCSP)
受电子产品的小、轻、薄的驱动,封装领域也是不断开发出新的封装type。上一章就有说到CSP封装就是比较革命性的产品,Size是裸芯片的1.2倍甚至同等大小,尤其随着移动电子的兴起,这种裸芯片封装(Wafer Level CSP)封装已经是最小最省钱的封装方式了,虽然前期需要RDL的光罩费用,但是它省去了Leadframe的费用,直接solder bump焊接到主板上即可。
CSP(Chip-Scale or Chipe-Size Package)的concept起源于1990s,follow的是IPC/JEDEC J-STD-012标准,它主要应用于Low pin count的EEPROMs、ASICs 以及microprocessors (MCU)等,尤其当Wafer越大而Die又越小的时候,其成本会更有优势。
CSP封装主要的步骤为: 把die mount到epoxy interposer上,再用wire bond (gold or Al)将PAD和基板连接起来,第三步用MoLDIng Plastic封装保护Die和Wire,最后再将Solder ball贴到Interposer底部。

当然上面的wire bond会让封装比起die size还要大一点。而且从die到lead frame上的导线还有连接阻抗的,后来发展到用bump代替wire bond,所以就发展到Flip chip代替Wire bond封装,这样就节省了wire bond的空间了,所以就可以做到Die几乎等size的package了。
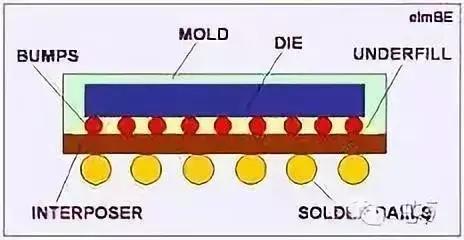
那说到倒片封装(FC: Flip-Chip),自然就要讲到这个bump了,不可能把die切割了再去长这个bump吧,所以必须在Wafer还没切割之前就做完这个process,所以就叫做Wafer Level CSP封装了 (WLCSP)。
Flip-Chip封装主要的三个步骤,Die上长bumps,脸朝下把长好球的die贴倒贴到衬底或者基板上,然后填充(underfilling)。
WLCSP现在已经是封装技术的主流,主要有两种,一种是直接BOP (Bump On Pad),还有一种是RDL (Redistribution Layer)。BOP技术还需要根据是否需要Polymer做re-passivation,再分为BON(Bump on SiN)和BOR (Bump on Repassivation)。BOP广泛应用于Analog/Power封装,它由于电流是直接垂直流过,没有横向RDL,所以对于功率器件封装很有优势,Cost也很低,但是它的Pin count比较有限,所以才发展到RDL Bump。BOP是直接把UBM/Bump锚在Top Metal的PAD上,而RDL Bump是用Polymer (Polyimide或PBO) 隔离并布线并且把Bump与device surface隔开。

再简单讲一下RDL Bump 铜柱的工艺流程吧,和FAB工艺差不多吧,四层光罩即可。RDL之间的dielectric用Polyimide隔离。Metal可以用电镀长上去(Seed用Sputter)。

成型之后的RDL Bump就是如下图的样子:

最早的WLCSP是Fan-In的,意思就是bump全部长在die上,而die和Pad的连接主要就是靠RDL的Metal Line来连接的。与之对应的就是Fan-Out的WLCSP封装,这就是把bump长到chip外面去了 (1.2倍),面积大点,bump的压力不会对芯片造成损伤。

讲solder ball之前,还是总结一下Flip-Chip和WLCSP之间到底区别是什么?Flip-chip一般还是需要衬底的,只是它通过solder ball倒装贴上去的(代替Wire bond)而已,而WLCSP是把长好的球做好之后直接贴到PCB板上去。
好了,不管是Flip-Chip还是WLCSP都需要一个东西叫做Solder Ball (锡球),那接下来该讲解Solder Ball了,这些Bump是怎么长上去的。
先讲讲为啥用锡球?那就要回答一个问题,Solder Ball的技术要求是什么?






免责声明:本公众号所载文章为本公众号原创或根据网络搜集编辑整理,文章版权归原作者所有。如涉及作品内容、版权和其它问题,请跟我们联系!文章内容为作者个人观点,并不代表本公众号赞同或支持其观点。本公众号拥有对此声明的最终解释权。
我司销售以下尖端工艺设备:

高精度激光直写光刻机(LDI)
应用范围:1) 半导体、2) 仿生材料、3)PCB 、4) 掩膜板、5) R&D




全自动晶圆涂胶植球封焊一体机

印制板快速3D打印系统



设备功能:激光植球、激光倒装焊、三维堆叠封装、晶圆凸点植球焊接、基板植球焊接、微焊点立体精密焊接,异形器件封装焊接、TSV孔填充工艺。

晶圆清洗(显影)机

两段式匀胶机

半自动旋转涂胶机(可规划1/2/3/4头喷涂机)

手动光刻机
优点:
专利平整校正机构/高精度/人性化操作介面/依制程需求模组客制化
可选配双面对准制程:
背面IR(红外光对准)/背面可见(背面CCD /显微镜对准)

半自动光罩对准光刻机
应用范围:半导体(Semiconductor)
微机电(MEMS)
被动元件(Passive Component)
触控面板(Touch Panel)
显示面板(Display Panel)
光二极体(LED)

全自动双面对准光刻机
应用范围:半导体(Semiconductor)
微机电(MEMS)
被动元件(Passive Component)
触控面板(Touch Panel)
显示面板(Display Panel)
光二极体(LED)

顺星电子招贤纳士
欢迎有志之士加入
职位:半导体设备销售人才
岗位需求:
1、有半导体设备行业销售经验,能积极拓展半导体相关设备销售机会;
2、能够积极开发新项目,新客户,陌生拜访客户。
3. 电子类,微电子、MEMS、机电一体化、计算机类相关专业优先;
4. 两年以上微电子领域相关工作经验,对工艺和器件有较深的理解,从事过相关工作的人员优先;熟悉半导体行业,了解半导体晶圆、封测等制程工艺,具备半导体设备销售经验者优先;
5 具备较强的销售能力及谈判能力,熟悉商务流程,能够独立组织开展销售工作;
6、具有敏锐的市场洞察力和分析能力,执行力强,具备团队合作精神;
7、诚信、敬业,事业心强,强烈的开拓进取精神,积极完成销售任务.
薪资待遇:面议
招聘热线:
电话:029-88214933
陈经理:18702963581
地址:西安市南二环西段紫竹大厦B座1501室
关注·分享∣一个有用的公众号

免责声明:本文仅代表文章作者的个人观点,与本站无关。其原创性、真实性以及文中陈述文字和内容未经本站证实,对本文以及其中全部或者部分内容文字的真实性、完整性和原创性本站不作任何保证或承诺,请读者仅作参考,并自行核实相关内容。文章投诉邮箱:anhduc.ph@yahoo.com