硅纳米管的制备(超临界流体工艺制备高性能碳化硅金属氧化物半导体场效应晶体管)
碳化硅 (SiC) 是电力电子领域中最重要的半导体材料之一,在新能源汽车、太阳能和风能等领域有着广泛的应用前景。SiC功率器件目前的市场份额已经超过15亿美元并且呈现出越来越迅速的发展趋势,预计在2025年SiC功率器件总市场份额将超过35亿美元。SiC MOSFET技术的成熟是当前碳化硅功率器件大规模应用最重要的技术关隘。其核心技术瓶颈是SiC MOSFET 栅氧层界面质量差导致沟道迁移率低(通常低于10 cm2/V·s),使得沟道开态电阻过高,能源转换效率严重受限。低沟道迁移率主要是由于在SiC热氧化形成二氧化硅(SiO2)过程中,在SiO2/SiC 界面产生高密度的界面态。研究表明靠近SiC/SiO2界面的碳残留是导致高密度界面态的主要原因。目前,降低这种界面缺陷的标准程序是在一氧化氮 (NO) 或一氧化二氮 (N2O) 中高温退火,称为后氧化退火 (POA),其典型温度范围为 1000°C至1500°C。然而这样的高温钝化工艺,无法避免界面处再氧化而导致额外缺陷,从而严重限制了界面质量的提升效果。此外,在磷基环境中进行高温退火和使用沉积的高 k 电介质(如三氧化二铝)来代替热氧化物等技术方案,则往往导致栅氧层可靠性的降低和较高的漏电流。SiC MOSFET的栅氧层界面质量问题是该领域的重大技术瓶颈。

低温超临界流体设备和横向硅(Si)面SiC MOSFET器件示意图
为解决以上技术瓶颈,西安交通大学微电子学院耿莉教授、刘卫华教授团队与西安电子科技大学郝跃院士共同合作,提出了一种使用低温超临界二氧化碳(SCCO2) 或超临界一氧化二氮 (SCN2O) 流体的低温退火工艺,以提高4H-SiC MOSFET中4H-SiC/SiO2界面的质量。通过增加压力,二氧化碳(CO2)和 一氧化二氮(N2O) 在接近室温时更容易进入超临界流体 (SCF) 状态。SCF态是物质的一种特殊相,它具有气体一样的高渗透能力和液体一样的高溶解度,几乎没有表面张力,因此,可以将 SCCO2或 SCN2O 流体引入界面来减小陷阱,而不会造成新的损伤。实验证明,使用SCF在120°C下进行的退火工艺在提高 MOSFET 器件中的 4H-SiC/SiO2质量方面非常有效,在 (0001) Si 面上制造的横向 4H-SiC MOSFET 的峰值场效应迁移率高达72.3 cm2/V · s,大约是氮氧后氧化退火工艺的最新结果的两倍。低温避免了高温的再氧化和材料分解问题,因而显著提高了介电层的可靠性。该研究成果不仅实现了高质量的SiO2/SiC界面、高的沟道迁移率和介电可靠性,更令人鼓舞的是,所提出的高效低温退火工艺与标准 SiC MOSFET 制造工艺兼容,为制备高性能SiC MOSFET器件提供了新的有效方法,方便用于商用器件的制备。
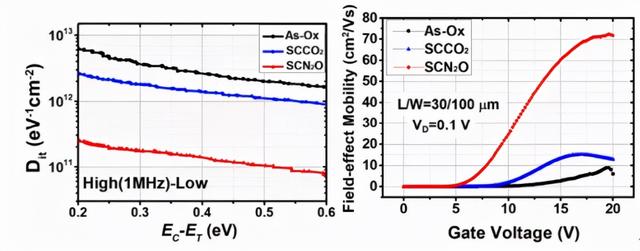
超临界流体工艺处理后获得高质量的SiO2/SiC界面和高迁移率的SiC MOSFET
近日,上述研究成果论文在第67届电气电子工程师学会(IEEE)国际电子器件会议(International Electron Devices Meeting, IEDM)上发表,论文题目为:“超临界流体低温退火工艺实现高性能”(Toward High Performance4H-SiC MOSFETs Using Low Temperature Annealing Process with Supercritical Fluid)(IEDM 36.2.1-36.2.4 (2021))。王梦华是学生第一作者,杨明超老师是第二作者,刘卫华教授、耿莉教授和郝跃院士是论文的通讯作者,西安交通大学为第一单位和通讯单位。该工作获得了国家重点研发计划、国家自然科学基金、西安交通大学基本科研业务费的支持。
来源:西安交大
,免责声明:本文仅代表文章作者的个人观点,与本站无关。其原创性、真实性以及文中陈述文字和内容未经本站证实,对本文以及其中全部或者部分内容文字的真实性、完整性和原创性本站不作任何保证或承诺,请读者仅作参考,并自行核实相关内容。文章投诉邮箱:anhduc.ph@yahoo.com






