cmos器件工艺(CMOS工艺流程详解说)
CMOS工艺流程介绍
1.衬底选择:选择合适的衬底,或者外延片,本流程是带外延的衬底;

2. 开始:Pad oxide氧化,如果直接淀积氮化硅,氮化硅对衬底应力过大,容易出问题;
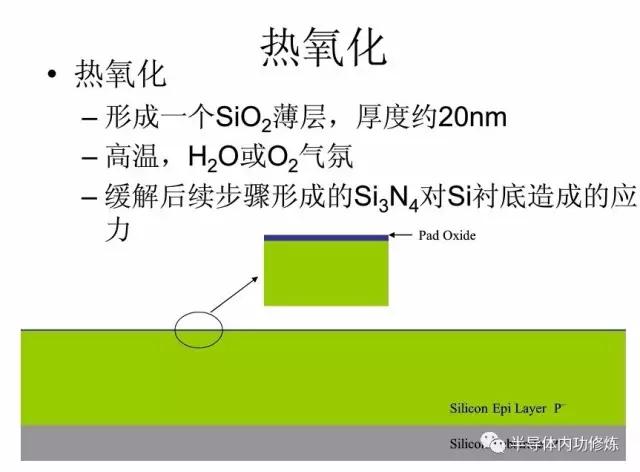
接着就淀积氮化硅。

3. A-A层的光刻:STI(浅层隔离)

(1)A-A隔离区刻蚀:先将hard mask氮化硅和oxide一起刻掉;

(2)STI槽刻蚀:Si3N4的刻蚀菜单刻蚀硅速率过快,不好控制,需要分开刻蚀;

(3)刻蚀完成后去胶,为了节省空间,后面的层次去胶将会用一句话带过;

(4)STI用氧化硅填充:这里没有讲,其实刻蚀STI会对衬底造成损伤,一般要先长一层薄氧化层,然后再腐蚀掉的,这样可以消除表现损伤;
STI填充:HDP高密度等离子淀积STI槽,用其他机器填充会提前将STI槽封死,里面会出现空洞,HDP机台是一遍淀积,一遍刻蚀,可以防止提前封口;

(5)简单的做法是直接CMP将二氧化硅磨平,但一般该步骤直接CMP会造成STI表面下陷,STI槽不满的情况,一般还会再加一层,将STI区域保护起来,将中间区域刻蚀掉,然后再CMP,这里简化处理。

(6)热磷酸腐蚀掉氮化硅,这个不叫常规;


4. Nwell光刻、注入:光刻前都有一层pad oxide,这里也没有画。

Nwell注入:一般要注一个阱,一个防传统注入,一个VT调节注入,三次注入分别对应深,中,浅,注入玩去胶,准备做Pwell注入;

5. Pwell光刻、注入:方式与Nwell类似,注入改为B注入,然后去胶,去胶后要将Nwell和Pwell一起推进,使两者有一定的结深和浓度梯度;




6. Gate栅的形成:腐蚀掉表现氧化层,再长一层牺牲氧化层,然后再腐蚀掉牺牲氧化层;




(2)POLY淀积:淀积 Insu-Poly,或者后面掺杂后再光刻

(3)POLY光刻、刻蚀:光刻Gate,并刻蚀POLY,然后去胶;



(4)POLY氧化:作为SI3N4 spacer刻蚀的停止层;

7. NLDD/PLDD的形成:
(1)NLDD光刻,注入,去胶;


(2)PLDD光刻,注入,去胶;


(3)Si3N4 spacer的刻蚀:氮化硅淀积及刻蚀


8. NSD/PSD形成:
(1)NMOS的源漏注入:Si3N4 spacer挡住的区域NSD注入注不进去,因此NSD区域要离开gate一小段距离;


(2)PMOS源漏注入:做完PSD,一起做一次RTP来退回,激活离子。



(2)contact孔光刻即刻蚀:

9. Salicide:Ti与硅形成低阻层Salicide;



(2)contact孔光刻即刻蚀:

10.ILD淀积及contac形成:
(1)BPSG淀积及CMP抛光。


(2)contact孔光刻即刻蚀:


W-plug:W塞淀积及CMP。




11. Metal-1淀积及光刻,刻蚀:




12. IMD淀积, CMP及Via光刻、刻蚀:
(1)IMD淀积,CMP抛光:





13. Via-W plug淀积,CMP:基本与Conctact W-plug一样的做法;




(1)Metal-2淀积:

(2)Metal-2光刻刻蚀



15. 钝化层淀积及钝化层光刻、刻蚀、去胶:钝化刻蚀后一般要做一步alloy。



对于高级一点的工艺,可能会有更多层的metal,做法类似,继续Via和Metal的堆叠即可。
会有更多层的metal,做法类似,继续Via和Metal的堆叠即可。
内容转载自网络,仅供学习交流使用,如有侵权,请联系删除。如果你还想了解更多关于电子元器件的相关知识及电子元器件行业实时市场信息,敬请关注微信公众号 【上海衡丽贸易有限公司】
,免责声明:本文仅代表文章作者的个人观点,与本站无关。其原创性、真实性以及文中陈述文字和内容未经本站证实,对本文以及其中全部或者部分内容文字的真实性、完整性和原创性本站不作任何保证或承诺,请读者仅作参考,并自行核实相关内容。文章投诉邮箱:anhduc.ph@yahoo.com






